近日,我院于大全教授团队在《IEEE Electron Device Letters》杂志上发表题为“Development of Compact Millimeter-Wave Antenna by Stacking of Five Glass Wafers with Through Glass Vias”的研究成果,报道了利用先进工艺在玻璃衬底上制备微纳结构再进行5层堆叠后制备毫米波天线的成果。
封装天线(AiP)作为毫米波天线与其他电子器件集成的解决方案,可以极大地提高布线密度,缩短天线与其他微纳器件的互连线长度。毫米波天线工作频率高,物理尺寸小,加工工艺复杂且精度要求高。传统天线基板材料(LTCC和PCB)的工艺精度差(>40 μm),且与布线金属的热膨胀系数不匹配导致的翘曲容易引起工艺偏差。
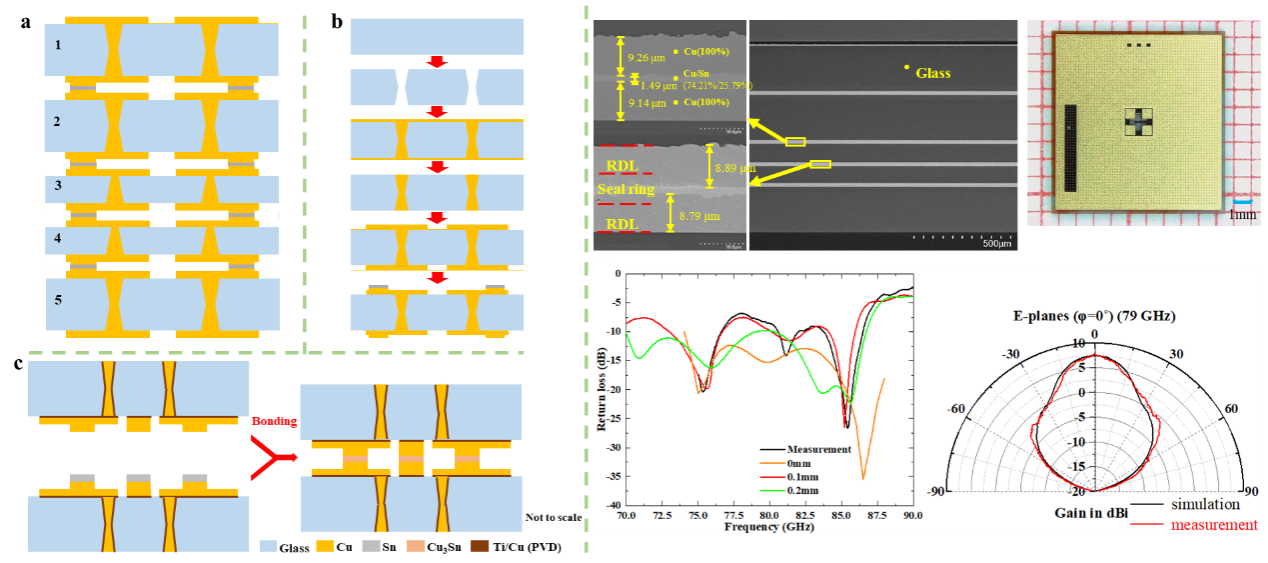
基于玻璃衬底的封装工艺具有高精度和低成本的特点,玻璃通孔(TGV)技术可实现三维互连结构。于大全教授团队成功地将多层玻璃基板堆叠的方式运用于毫米波封装天线的设计与制造。采用高能量密度的皮秒激光对玻璃晶圆进行永久性诱导损伤,再以湿法刻蚀方式形成高深宽比的玻璃通孔;配合电镀铜填实技术实现片内信号互连。随后,各层晶圆独立加工形成再分布层(RDL)与铜锡键合层,采用低温铜锡互扩散共晶键合技术将各层逐次键合堆叠。铜锡反应产生的铜锡化合物,提供了高可靠性和低损耗的片间信号传输。该研究工作旨在利用三维堆叠技术在结构的Z轴方向上形成三维集成,更适用于天线与大多数器件的集成,有利于毫米波天线的小型化设计。
该项工作联合了厦门云天半导体科技有限公司和航天科工微系统技术有限公司合作完成,于大全教授为论文通讯作者,2019级硕士苏仰泉为第一作者。研究工作得到了国家自然科学基金(No. 61974121)等科技计划资助。
图文:苏仰泉
